获取报告请登录未来智库。
投资主题报告亮点
2、我们认为高端通讯板的结构性增长要强于整体行业,高端产品的竞争壁垒高于市场认知。目前高端的通讯板供应商主要为深南沪电生益,市场认为PCB产业较为低端,高利润率不可持续,未来大量二线厂商介入挤占龙头份额的利润率。我们认为整体PCB行业受经济增速制约不会增长太快,高端通讯板因技术升级呈现结构性增长,由于高端材料应用、加工难度升级,层数升级,工艺难度显著提升,龙头厂商的技术积累深厚,二线厂商在良率和量产能力上需要较长时间追赶,目前尚未看到有明显竞争力的二线厂商大举介入。因此龙头厂商能够享受较长时间的行业红利。
投资逻辑
一、流量驱动高端通讯板景气提升,应用场景落地扩容行业空间

展望5G时代,随着网络带宽进一步突破瓶颈,低时延网络的普及,新型的产业应用有望真正落地。车联网与自动驾驶有望最快落地,车联网能够提高道路安全水平和车辆流传的效率,从而使交通更加顺畅无阻。而在物流领域,智能连接具有提高商品递送效率和灵活性的巨大潜力,使物流更快、更便宜。在工业领域,智能连接有助于提高生产力,减少人为错误,从而降低成本并提高工人的安全性。远程操控也能减少对现场工人的需要,从而增加生产设施位置的灵活性,工厂自动化和工业机器人的远程控制、远程检查、维护和工人的培训。在医疗领域,智能连接有助于以更经济的成本提供更有效的预防保健护理,同时帮助医疗健康的管理者优化资源的使用。此外,智能连接也会进一步促进远程诊断和远程手术的发展,甚至彻底改变目前医疗行业医学专家们受制于地理位置的局面。
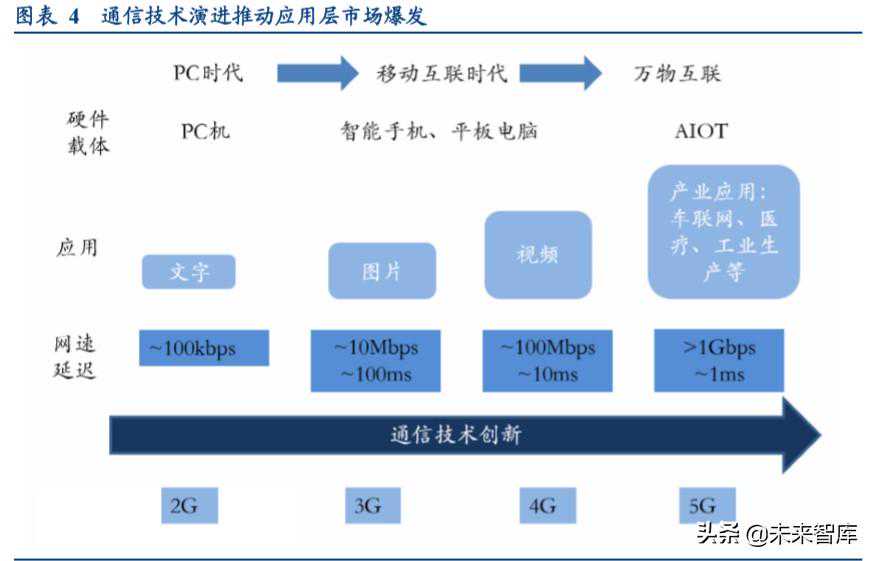
伴随新型应用落地,5G流量有望突破当前的基础设施瓶颈,服务器数据中心等需求有望维持较长时间景气周期,流量的持续扩容会反哺基础设施建设需求,高端通讯板作为数据传输的载体,景气周期有望贯穿整个5G周期。
二、5G新基建提速,基站及IDC带动高速/高频PCB放量PCB下游创新不断,通信和服务器子行业增速相对较快。PCB作为电子产品之母,下游应用广泛,包括通信、计算机、消费电子、工控医疗、汽车电子、航空航天、封装基板等。在PCB主要下游应用中,PC、手机、TV等产品出货量进入平稳期,通信和服务器是未来行业增长的主要动力。5G通讯从2019年起到2020年逐步进入建设高峰期,据Prismark预计,无线基建相关的电子系统市场规模将从2018年640亿美元提升至2022年840亿美元,%;服务器/存储市场规模将从2018年1560亿美元增长至2022年1730亿美元,%。据Prismark统计,2018年全球PCB总产值约635亿美元,同比增长约8%。5G时代PCB有望保持平稳增长,预计到2021年全球PCB行业产值将达到703亿美元。

5G时代技术升级带动高频/高速PCB需求提升。高频PCB是电磁频率较高(1GHz以上)的特种电路板;高速PCB指数字电路速率达到或超过45MHz-50MHz,且这部分速率的信号站整个系统1/3以上。5G时代MassiveMIMO技术的应用使得基站硬件架构发生显著变化,对PCB提出了更高的技术要求,AAU部分,作为基站最前端接收装置,天线和射频对于介质传输损耗要求极低,对导热性要求极高,天线和射频用的高频板材的损耗和导热要求高于主设备其他结构的应用需求,频段越高,对传输速率、介质损耗的参数要求标准越高,因此需要用到更多的高频板材;DU与CU部分,由于5G数据较4G大幅增加,需要使用高速高层电路板以提升数据处理能力。
高频/高速覆铜板的核心要求是低介电常数(Dk)和低介质损耗(Df)。高速和高频覆铜板是在玻璃纤维布基CCL的基础上,通过使用不同类型的树脂实现的,其核心要求是低介电常数(Dk)和低介质损耗因子(Df):介电常数(Dk)越小越稳定,高频高速性能越优;介质损耗(Df)越小越稳定,高频高速性能越优。高频/高速PCB的加工要求较高,ASP约为传统PCB的两倍。

(一)5G基站于2020年加速铺设,PCB产业链持续受益
1.疫情之后政策导向加速科技基建推进力度,通讯PCB产业景气度有望继续上行
5G商用提前带动运营商资本开支回升。2019年6月6日,工信部正式发放5G商用牌照,宣告5G商用元年,较原计划提前一年。从三大运营商资本开支角度看,3G建设周期始于2006年,至2009年达到高峰,4G建设周期始于2013年,至2015年达到高峰,2019年进入5G建设新周期,运营商资本开始首次转正,根据历史规律,2020-2021年运营商的资本开支将持续增长。

2.PCB产业链持续受益于5G基建建设
5G转移至高频段,基站数量有望提高。由于低频(3KHz-300MHz)通信频段拥挤,为了提供更快的传输速度,5G所用频段向高频率(3GHz+)转移,而高频信号衰退速度快,为了满足覆盖范围,必须建造更多基站。目前5G频率约为4G频率的两倍,理论上5G基站数量应为4G基站的4倍,但考虑到技术提升带来的高功率、多天线设计以及运营商采用的SA和NSA混合方案,实际数量存在一定折扣,根据中国产业信息网预测,5G基站数量将是4G基站的1.1-1.5倍。截至2018年底,我国4G基站数达到372万座,5G基站总数有望超过500万座。PCB作为基站的重要材料之一,将受益于基站总数提升。
受益于高频高速产品用量提升,5G时代单站PCB价值量显著提升:1)从铺设数量看,全站5G基站有望达到4G基站的1.3倍左右;2)5G基站天线数量大幅增加(从十几根到几百根),天线数量增长带动单基站所需PCB增加;3)5G基站中高频/高速PCB的占比增加,整体ASP约提升1.3倍。总量与单价共同提升,5G时代PCB价值量有望达到550-600亿元,约为4G时代的两倍。

(二)服务器行业于19Q3逐步回暖,高速PCB迭代升级再添驱动力

疫情快速打开在线应用市场,云计算行业深度受益。受疫情影响,在线办公/教育等线上需求激增。“钉钉”2月首次超过微信,跃居苹果应用商店免费App排行榜第一,“企业微信”、“腾讯会议”名列第三和第四。据新闻报道,2亿+在线需求给钉钉后台带来巨大压力,钉钉在2月3日紧急扩容1万台服务器,2月4日再度扩容1万台。长期来看,此次疫情帮助云企业快速完成市场教育,疫情结束后有望留存部分长期用户,当前或为国内在线办公/教育等行业加速发展拐点,
云计算为服务器主要增长点,19Q3起行业拐点已至。根据Prismark的预测,数据中心/服务器用PCB市场在2018-2023年的复合增速将达到5.8%,显著高于行业平均的3.7%,也是仅次于无线基站增速的高成长性板块。服务器行业景气度主要受上游云计算厂商资本开支影响,受益于云计算需求的提升,服务器行业自17Q1进入高景气周期,行业快速增长,18年受全球经济增速下滑和中美贸易战影响,服务器上游云巨头减少资本开支,服务器行业增速开始放缓。从需求角度看,海外云计算巨头资本开支增速于19Q2由负转正,19Q3增速进一步回升;从供给角度看,国内外服务器相关企业业绩增速于19Q3探底回升,随着5G商用推进,2020年行业有望保持高增速。

CPU厂商加快技术升级节奏以应对市场竞争。英特尔在去年的投资者会议中透露,将于今年推出CooperLake-SP和IceLake-SP,并于21/22年推出SapphireRapids-SP(10nm)和基于下一代Xeon的GraniteRapids-SP。近年来在服务器CPU市场,AMD凭借技术突破快速扩张市场份额,ARM激进加码服务器领域,为应对竞争压力英特尔将产品迭代周期从5~7个季度缩短至未来4~5个季度,并显著提升技术升级节奏。将于Q2推出的IceLake-SP首次采用10nm工艺节点,并能够支持,产品性能效率将大幅提升。
AMD另辟蹊径,技术革新突破摩尔定律桎梏。19年AMD发布EPYC二代服务器CPU,凭借64核128线程,7nm制程和对领先的标准的支持,以及远低于同类产品的成本,一经发布便在全球服务器市场掀起了声势浩大的64核性能革命,已经创造了超过140项的世界纪录,是迄今为止性能最强大的X86处理器。在英特尔受限于摩尔定律带来的成本压力无法提升核心数量时,AMD另辟蹊径,采用小芯片架构有效提升核心数量,通过将CPU与IO单元分离,用一个IO连接所有CPU核心。其创新性小芯片架构大幅缩减IO单元面积,从而做到在控制成本的前提下大幅提升核心数量,进而带动CPU性能大幅提升。
ARM入局引领服务器CPU/基础架构市场技术革新。18年10月ARM宣布推出NeoverseN1/E1服务器平台及ArmServerReady规范,希望通过新一代处理器平台设计及合作规范确定提高其在服务器和基础设施领域的竞争力。NeoverseN1以构建高性能架构作为设计目标,x86阵营面向高性能平台的产品受制于功耗、面积等因素,频率相比消费级产品更低,但是在ARM的设计中处理器频率更高,这也导致ARM产品性能优势明显。19年2月ARM公布了采用7nm工艺设计的NeoverseN1CPU具体参数信息,NeoverseN1延续CortexA76架构并针对架构设计大幅调整优化以适应Neoverse平台高性能策略,NeoverseN1CPU在SPECrate2006多线程测试中以极高的性能和效率表现战胜了AMD/英特尔旗舰服务器产品。ARM服务器产品主要瞄准5G、边缘计算、IoT等高吞吐处理器市场,预计在5G时代将改变传统服务器市场x86阵营一家独大的格局,并迫使AMD/英特尔推进技术创新节奏。

CPU性能迭代进程加快,推进服务器更新换代节奏。芯片市场竞争加剧导致行业主要玩家均加大技术研发投入,产品技术升级迭代进程大幅加快,19年以来英特尔新品发布周期大幅缩短,且预计于20年接连发布两款新品以应对市场竞争;AMD于17年发布的创新性ZEN架构对芯片IPC优化提升高达52%,19年的ZEN2架构进一步升级,较去年ZEN+设计IPC进一步提升15%,缓存容量及浮点计算能力实现翻倍,芯片性能大幅提升达行业领先水平;ARMNeoverseN1芯片性能表现已接近x86旗舰水平,且ARM持续加码技术投入,公司预计未来每年保持25~30%的性能提升,大幅超越Intel和AMD的迭代幅度。CPU性能快速提升直接导致终端服务器产品性价比大幅提升,在5G时代服务器端算力需求爆发增长的大背景下,服务器更新换代周期有望显著缩短。

升级利好高速PCB需求持续提升。PCIe是一种高速串行计算机扩展总线标准,由英特尔在2001年提出,旨在替换旧的PCI,PCI-X和AGP总线标准。2019年的台北电脑展上AMD发布了第3代锐龙桌面计算机处理器以及AMDX570主板,是全球首款支持规范协议的PC平台,标志着开始正式落地。之前的,其信号速率为8GT/s,编码方式是128b/130b模式,即每传输128个Bit,需要发送130个Bit。也就是说协议的每一条Lane支持8*128/130=7.877Gbps=984.6MB/s的速率,一条的通道,x16的可用带宽为7.877*16=126.031Gbps=15.754GB/s,双向带宽高达31.5GB/s。而,则是将带宽再翻一倍,双向传输速度可达到64GB/s。

落地带动服务器向高端升级,高端服务器中使用的PCB板主要为4类:1)背板,用于承载各类Linecards,板厚4mm以上,层数往往超过20层;2)LC主板,一般在16层以上,板厚在2.4mm以上,外层线路线宽线距设计通常在0.1mm/0.1mm及以下,并对信号损耗有着较高的要求;3)LC以太网卡,10层以上,板厚1.6mm左右;4)Memory卡,受面积限制,通常在10层以上,线宽线距0.1mm/0.1mm及以下。基本上都需要使用高频高速多层板,普遍在十层以上,其要求标准甚至比5G基站中使用的高频高速板还高,技术壁垒和价值量也相对更大,服务器行业技术升级将显著提高高速高层PCB的占比,为高速高层PCB再添驱动力。
三、高速板:基站及服务器PCB层数及性能要求提升,考验高端PCB厂商设备及产能水平高速板的诞生可以追溯到上世纪80年代,当时主要指与普通板相比TTL更快,路径更长的PCB产品,早期主要用于IBM和Cray等公司设计和制造的大型计算机。通常如果一个数字系统的时钟频率达到或者超过50MHz,而且工作在这个频率之上的电路已经占到了整个电子系统一定的分量(如1/3),即可称为高速电路。但在具体应用中高速不等于高频,不能简单用MHz定义,实际上高速设计和信号上升沿有直接关系,高速PCB设计时需考虑有效频率,当信号的上升时间和信号的传输延时可比拟的时候(如信号上升时间小于3~6倍传输延迟)才可称为高速设计。
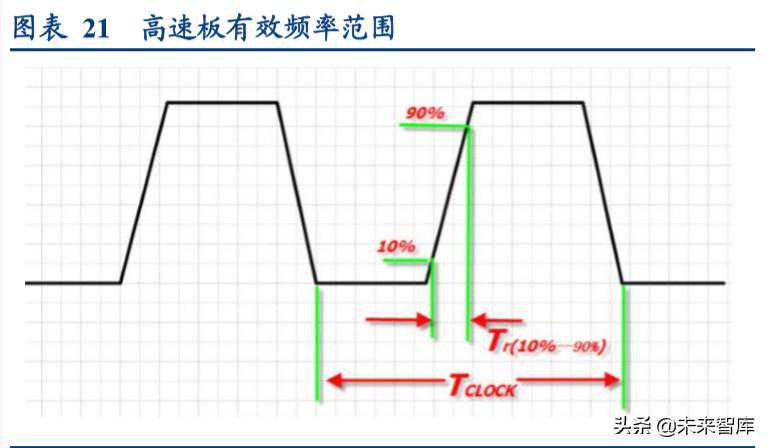
高速数字电路的设计主要研究互连对信号传播的影响、信号间的相互作用,以及和外界的相互作用。与低速情况下的数字设计相比,高速设计着重强调了数字电路之间用来传输信号的路径和互连,从发送信号芯片到接收信号芯片间的完整的电流路径,包括封装、走线、连接器、插座,以及许多其他的结构。

高速PCB生产过程较为复杂,需综合考验企业的设计开发、品质管控能力,且随着PCB板层数的提升,对压机、钻机等核心设备的产能及技术水平要求也逐渐提升,对企业的资本投入要求提升,因此具备资本及技术积累的先发企业竞争优势明显,目前国内仅深南、沪电、生益电子、崇达技术等头部厂商可实现高速板规模化生产。
(一)5G基站建设带动高速PCB板需求快速增长
4G时代,一个标准的宏基站主要由基带处理单元(BaseBandUnit,BBU)、远端射频单元(RemoteRadioUnit,RRU)和天线组成。远端射频单元(RRU)通过接口与BBU通信,完成基带信号与射频信号转换。RRU主要包括上、下行信号接口单元、处理单元、功放单元、低噪放单元、双工器单元等,构成下行与上行信号处理链路。其中接口单元提供与BBU之间的接口,发送基带IQ信号;下行信号处理单元完成信号上的变频、数模转换、射频调制等信号处理功能;上行信号处理单元主要完成铝箔、混频、模数转换等功能;功放及低噪放单元分别对下行和上行信号进行放大;双工器支持收发信号复用并对收发信号进行滤波。
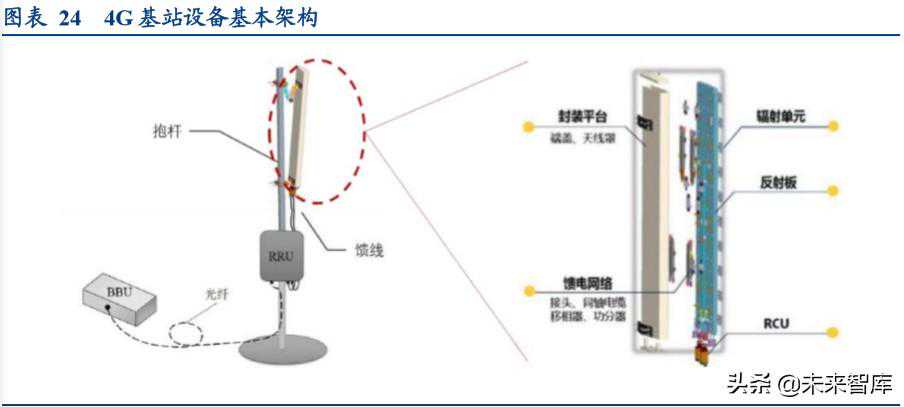
5G接入网架构相对于4G而言出现的重大技术变化之一是支持DU(分布式单元)和CU(集中单元)功能划分,为满足大规模物联网(mMTC)、增强移动宽带(eMBB)和低时延高可靠物联网(uRLLC)等要求,并提高资源利用率,目前通信厂商普遍采用CU/DU分离方案,即采用独立的DU设备和独立的CU设备,按照3GPP的标准架构,DU负责完成RLC/MAC/PHY等实时性要求较高的协议栈处理功能,而CU负责完成PDCP/RRC/SDAP等实时性要求较低的协议栈处理功能,该架构有利于实现多连接、高低频协作、简化切换流程、利于平台开放。
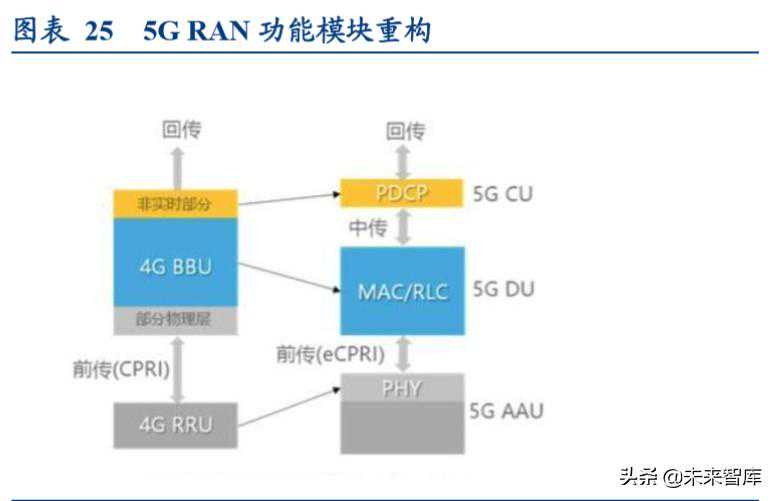
在基站系统中,高速板主要用于BBU(DU/CU),RRU中高频/高速板均有使用,此外天线系统也使用少量高速板。5G基站BBU中CU/DU的分离设计导致PCB数量提升,虽然总面积提升不大,但性能参数大幅提升导致单价大幅增长,单站高速板价值量大幅提升。据产业调研,5G基站中BBU用高速板共三块,单块面积约0.15㎡,单价8000元以上;收发单元中高速板面积约0.3㎡,单价3500元以上。
(二)服务器用高端PCB技术要求严苛,行业壁垒抬高头部厂商持续收益
云计算技术的逐步成熟为服务器市场的崛起提供了绝佳机遇,以云计算和大数据为标志的全新IT时代推动着服务器技术和市场的变革。随着5G时代虚拟化、云计算、桌面云、大数据、内存数据库应用和高性能运算等热点应用的发展,4路/8路等高端服务器市场份额逐步扩展。服务器市场逐步进入高速、大容量、云计算、高性能发展轨道,因此对PCB的设计要求也不断提升,如高层数、大尺寸、高纵横比、高密度、高速材料及无铅焊接等应用逐步推进。

高速板为在高频下低传输损耗的新型PCB板,主要应用于服务器背板和Memory卡,在高端服务器里应用范围更广。由于高速材料本身的材料特性,比较容易吸湿产生水汽分层,因此对企业生产过程中钻孔、压合等生产技术优化调整的要求较高。同时服务器性能带动高速板的性能需求逐步提升,如目前在单路、双路服务器上PCB板一般在4-8层之间,而4路、8路等高端服务器主板要求16层以上,背板要求则在20层以上,对高速板产品的厚度、线宽/间距、阻抗公差等参数要求也逐渐严苛,行业技术及资本投入壁垒逐步提升,深南电路、沪电股份等龙头PCB企业有望持续受益。
四、高频板:5G基站AAU/天线振子用量提升,上游材料环节附加值凸显高频板是指电磁频率较高的特种线路板,用于高频率(频率大于300MHz或者波长小于1米)与微波(频率大于3GHZ或者波长小于0.1米)领域的PCB,是在微波基材覆铜板上利用普通刚性线路板制造方法的部分工序或者采用特殊处理方法而生产的电路板。一般来说,高频板可定义为频率在1GHz以上线路板,通常用高密度FR4玻璃纤维板压制的,而普通板则通常采用低密度复合基板等材料压制而成。高频板主要用于:(1).移动通讯产品;(2).功放、低噪声放大器;(3).功分器、耦合器、双工器、滤波器等无源器件;(4).汽车防碰撞系统、卫星系统、无线电系统等高频应用领域。
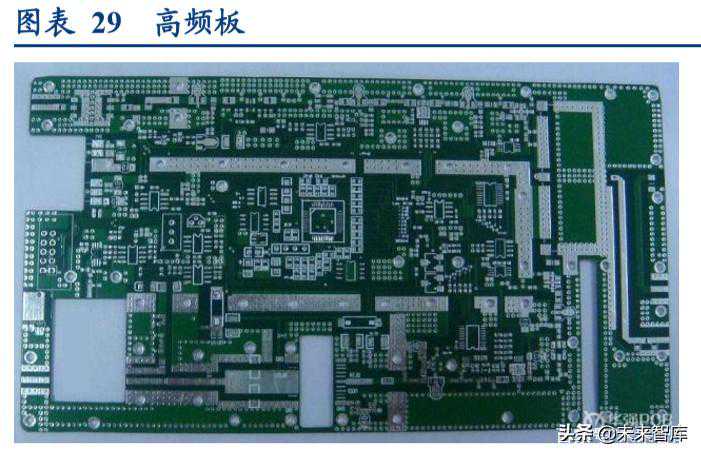
5G时代高频段应用推动基站天线从无源向有源演进,在主流设计中RRU与天线合并成有源天线单元(AAU)。与传统的由天线、RRU、BBU各自独立组成的分布式基站不同,5G主基站的AAU设计集成了天线和AAU功能,AAU主要由天线、功分网络板、耦合校准板、连接器和收发单元构成。功放单元中PA板需使用高频PCB生产,此外,由于5G天线密集辐射阵中天线在结构形式上需要小型化设计以适合密集组阵列,天线振子的馈电和安装也需与功分网络板配合,因此在生产中经常与功分板集成生产,部分天线振子可能采用高频设计,即部分功分板亦采用高频PCB。天线单元之间需通过耦合校准板进行集合,由此产生叠加增量空间,校准耦合板也采用高频PCB设计。

因此5G基站中高频板增量主要来自于PA板及耦合板。据产业调研推算,PA板普遍采用双面高频板,面积约0.1㎡,单价2000~3000元;AAU中耦合板面积约0.4㎡,采用双层及以上高频板,单价3000元以上。
五、高频/高速CCL:贸易战加速国产替代步伐,PCB产业上游环节价值量凸显(一)高频/高速CCL为5G基础设施升级核心上游材料,海外龙头罗杰斯(高频)/松下(高速)位于第一梯队
1.高频CCL是5G基站核心部件的关键原材料,用量将显著提升
辐射单元:振子是基站天线最核心的部件,其设计方案的好坏直接决定了天线的辐射性能。虽然辐射单元的结构形状各异,但从辐射原理上可分为微带贴片单元和振子单元两种方案,振子单元又有压铸成型、钣金组合成型、PCB印刷三种方式。目前在基站天线中,由于通信频率高数据流量大,对电性能要求非常高,PCB印刷辐射单元和压铸辐射单元是主流的两种振子方式。PCB印刷辐射单元由于加工精度较高且重量轻,在4G及5G通信的基站中优势更明显,但其电性能指标受PCB基材(即覆铜板)介电常数稳定性的影响较高,因此原材料必须选用介电常数稳定、介质损耗低的高频CCL。
馈电网络:馈电网络的作用一方面是能量传输,另一方面是将射频电能按照一定关系分配到各个辐射单元,是决定天线信号接受、传输、发射的关键部件。馈电网络有微带线馈电网络和同轴电缆馈电网络两种。目前基站天线生产商多选用PCB微带线馈电网络或PCB与同轴电缆混合型馈电网络。同样由于通信频率高且变化范围大,4G、5G基站的馈电网络中,PCB基材以高频覆铜板为主,因此也需要高频CCL。
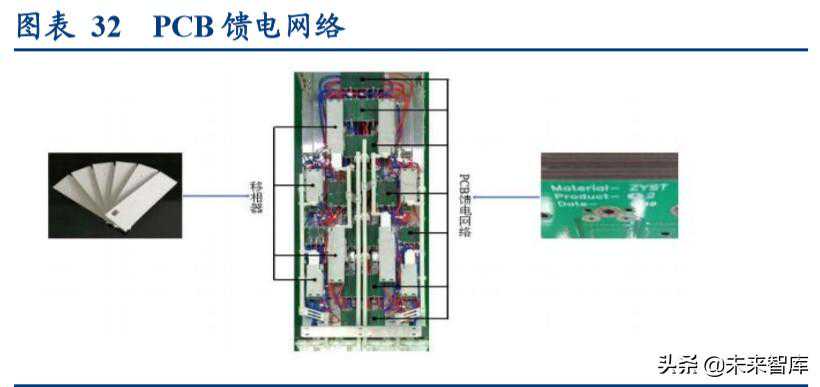
高频CCL主要分树脂型和PTFE型,5G时代PTFE型有望成为高频覆铜板主流。目前4G基站中,RRU中功放模块由于工作频率较高,其所用的PCB板要使用高频覆铜板为基材。基站中功率放大器的各主要元器件都是印刷在PCB电路中,其使用的高频覆铜板以碳氢化合物树脂高频覆铜板为主,PTFE高频覆铜板相对不具备性价比优势。但是在5G时代,为提高单个基站的覆盖面积,功率放大器的输出功率呈不断上升趋势,对PCB基材的散热性要求更加严苛,高导热性的PTFE高频覆铜板将逐渐成为趋势。
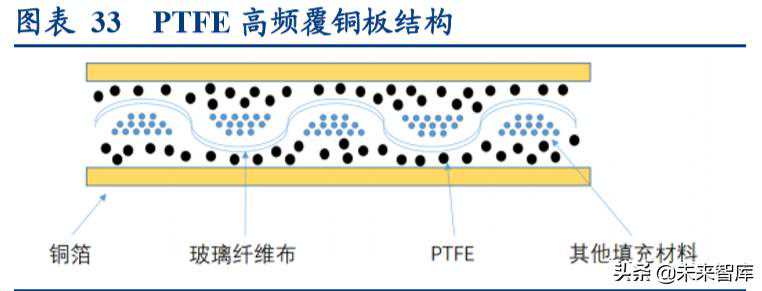
2.高速CCL受益于5G高速运算处理需求增长
高速覆铜板是一类在高频下具有低传输损失特性的新型PCB基材,其最大的特点在于两低两高:低损耗(lowDf、lowDk)、低传送信号分散性、高特性阻抗精度、高散热性。5G基站建设中需要大量使用高速CCL,此外随着5G商用,VR/AR、云游戏、车联网等应用将大幅提高对设备运算能力及服务器数量需求,高速CCL将迎来快速成长。
3.技术壁垒高、认证周期长,海外龙头罗杰斯(高频)/松下(高速)处于第一梯队
技术壁垒高、认证周期长、行业进入壁垒高。高频高速CCL对Df和Dk有严格的要求,加工工艺的精度要求较高,对产品的各种物理性能有严格的要求,包括高频覆铜板的尺寸稳定性、耐热性、平整性、铜箔与基板及基板材料层间的粘接性等。此外,高频高速CCL通过设备制造商的认证周期在一年以上,首次认证后,新产品获得设备制造商认证的时间也需要6-12个月,后来者想进入市场难度较高。
罗杰斯为高频CCL龙头。罗杰斯在上世纪50年代即开始持续投入对高频微波基板材料的研发;在70年代中期,其主打的短玻纤增强型的PTFE覆铜板已在军工、航空等领域有较好的应用;80年代中期以后,罗杰斯研发成功了陶瓷填充型PTFE覆铜板和陶瓷填充的热固性树脂高频覆铜板,奠定了高频覆铜板行业的技术标准;90年代初期,高频覆铜板进入商业应用发展时期,产品重点市场转为以移动通信为代表的民用市场;进入20世纪以来,高频覆铜板市场规模在移动通信行业有了爆发式增长,罗杰斯开发的PTFE高频覆铜板和碳氢树脂型覆铜板成功应用到基站天线和功率放大器系统中,有效提升了基站信号传输性能;近年来,罗杰斯将研发聚焦到5G通信和汽车领域,成功研发出适用于5G高频段通信和汽车毫米波雷达的RO3000型高频覆铜板,是目前行业内新的技术标杆。根据中国覆铜板协会预计,2018年罗杰斯在高频覆铜板的市占率约为50%-65%。
高速CCL技术难度低于高频CCL。松下自2001年来开始研发高速CCL,是全球高速CCL龙头,根据Prismark数据,2017年松下电工在高速覆铜板的市占率约为25%-30%。从毛利率(高频30%-40%,高速25%)和市场集中度可以看出,高速CCL的技术难度低于高频CCL。
国内高频高速CCL起步较晚,生益科技为国内龙头。国内高频CCL主要厂商有泰州旺灵、中英科技、生益科技、华正新材。生益科技于2016年8月设立子公司生产高频CCL,于2017年收购了日本中兴化成的PTFE高频材料全套生产设备、工艺和专利,公司2018年已有批量供应高频CCL。生益科技同时也具备高速CCL大规模生产能力,是高频高速CCL领域二线龙头。
(二)贸易战推动生益科技于第二梯队加速追赶
贸易战加速高频/高速CCL国产替代步伐。2019年5月17日,美国商务部称已将华为及70家关联企业列入其所谓的“实体清单”,以后如果没有美国政府的批准,华为将无法向美国企业购买元器件。市场传闻华为通信设备所用的高频CCL主要供应商罗杰斯将对华为断供。尽管罗杰斯并未对华为断供,且G20后美国政府又宣布美国企业可以在安全审查通过后对华为供货,但贸易战为中国敲响了警钟,为了供应链自主可控,国产替代的步伐会进一步加快。
生益科技或为高频CCL国产替代的主要受益者:1)目前国内仅生益科技一家具有大规模生产高频CCL的能力。产品已经通过华为等大客户的认证,公司作为国内企业,在成本、交付期限、配套服务上具备竞争优势,在供应链自主可控驱使下,市场份额将持续提高;2)目前公司的高频CCL性能参数已不输Rogers,可实现部分替代。
六、5G终端升级,HDI主板量价齐升(一)高密度轻薄化趋势下,HDI板成PCB主要增长点之一
移动终端用HDI板为PCB行业提供增长动能:智能手机、平板电脑等移动终端向着短小轻薄便携的特点发展,使得主板空间被压缩,而HDI采用积层法制板,运用盲孔和埋孔来减少通孔的数量,相对普通多层板在布线上具有密度优势,能够在有限的主板上承载更多的元器件,从而在手机中迅速取代了传统的多层板。随着移动终端功能不断增强和轻薄化的持续发展,HDI板的设计更多的向三阶甚至任意层HDI板发展。苹果在iPhone4和iPad2中首次采用任意层HDI,大幅度提升了产品的轻薄化程度。随后安卓阵营也迅速跟进,任意层HDI由此爆发成为当前中高端智能机的标配主板。据统计,从一阶HDI改使用任意层HDI,可减少四成左右的体积。预计未来任意层HDI将在越来越多的高端手机、平板电脑中得到应用。目前智能手机的三阶HDI与任意层HDI采用率约在30%,而平板电脑采用率更高达80%以上。我们认为,以智能手机为代表的移动终端仍将进一步驱使HDI板向更高密度更轻薄方向发展,移动终端用HDI板会是PCB主要增长点之一。

高端服务器拉升HDI整体需求:除了移动终端,高端服务器也将拉升HDI整体需求水平。目前8层以下的PCB主要用于家用电器、PC、台式机等,而高性能多路服务器、航空航天等高端应用都要求PCB的层数在10层以上。以服务器为例,在单路、双路服务器上PCB板一般在4-8层之间,而4路、8路等高端服务器主板要求16层以上,背板要求则在20层以上,因此更多的采用HDI板。
国内云计算市场的发展,移动支付、OTO应用、社交网络等移动互联快速扩张,带动中国服务器市场稳步增长,成为全球出货量的增长主力,且增速不断提高。2015年销售额498.2亿元,同比增长16.6%。可以预见,未来会有更多的高端服务器用于云计算。预计2016年至2020年,我国服务器市场销售额将保持21%左右的年增长速度,2020年达到1273.7亿元。
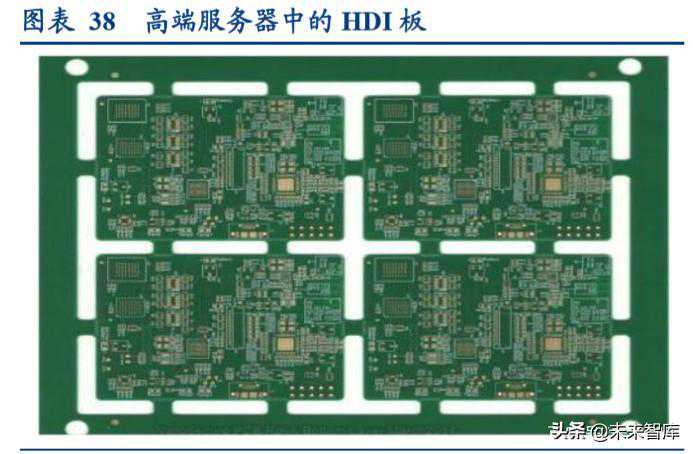
(二)智能手机升级,高阶HDI和SLP主板需求量增加
1.苹果手机:引领产业“创新”,SLP主板已逐步渗透
苹果引领消费电子市场发展,2017年率先将SLP主板应用于手机,三星步步跟进。2010年以前,苹果产品使用普通多层主板,自2010年起,苹果智能手机以及平板电脑主板采8-12层1-3阶HDI主板,2013年苹果创造性将AnylayerHDI主板应用于iPhone5S,2017年苹果更是引领市场率先在iPhoneX使用SLP主板。三星紧随苹果之后,在三星S9等旗舰机型使用SLP主板。由于类载板工艺有别于HDI工艺,产品良率和品质有待提升,现阶段还未在安卓系机型广泛应用,随着技术成熟度提升,SLP会加速渗透。
2.5G手机:AnylayerHDI已成标配

5G手机内部元器件进一步增多,在保持现阶段手机大小尺寸的情况下,对主板线宽、间距、内部元器件的集成程度提出了更高的要求,AnylayerHDI主板已成为安卓系的主流方案。2019年华为发布的5G手机mate20和P30均使用12层AnylayerHDI主板,OPPO和VIVO的5G机型紧跟华为步伐,使用12层AnylayerHDI主板。
(三)供给端产能扩张谨慎,供不应求有望催生涨价预期
根据prismark统计,全球HDI主板产值前10的企业占全球HDI主板大约56%的产值,中国台湾有6家上榜,约占全球产值30%;欧美两家企业上榜,约占全球产值16%;日韩3家企业上榜,约占全球产值9.4%。其中鹏鼎控股以做软板为主,高阶HDI硬板占比相对较低。三星电机2019年12月宣布关闭中国昆山HDI制造工厂,退出HDI市场。
1.新企业进入难度大,资金、技术、环保铸就行业高壁垒
资金、技术、环保指标加宽HDI企业护城河,新企业进入难度较大。HDI主板制造业属于重资产行业,生产一块HDI主板需要超过100到工序,激光钻孔设备、电镀设备、涂布设备等资本开支较大,低阶HDI主板投资/收入比例可达到约1:2,而高端HDI、SLP产线投资/收入比例仅低于1:1。另一方面,该行业还具备较高技术壁垒,HDI主板厚度轻薄化和线宽间距精细化,对生产工艺要求越来越高,企业产品良率的提升需要长期技术积累和设备性能改良,能将高阶HDI主板良率做到90%以上的企业已经相当优秀。此外,由于国内外一系列环保法律法规的颁布,环保壁垒成为HDI行业一个颇具特色的壁垒,我国各地方政府对环保指标审核严格,小企业很难进入该行业。
2.行业盈利水平一般,外资及台资企业扩产相对谨慎
全球主要HDI硬板制造企业平均毛利率15%左右,平均净利率波动上升。通过分析全球主要的HDI硬板厂商利润情况,2018年平均毛利率约15.29%,毛利率最高为18.74%(健鼎科技),毛利率最低为11.07%(欣兴电子);平均净利率约5.64%,净利率最高为9.48%(健鼎科技),最低为2.42%(欣兴电子)。
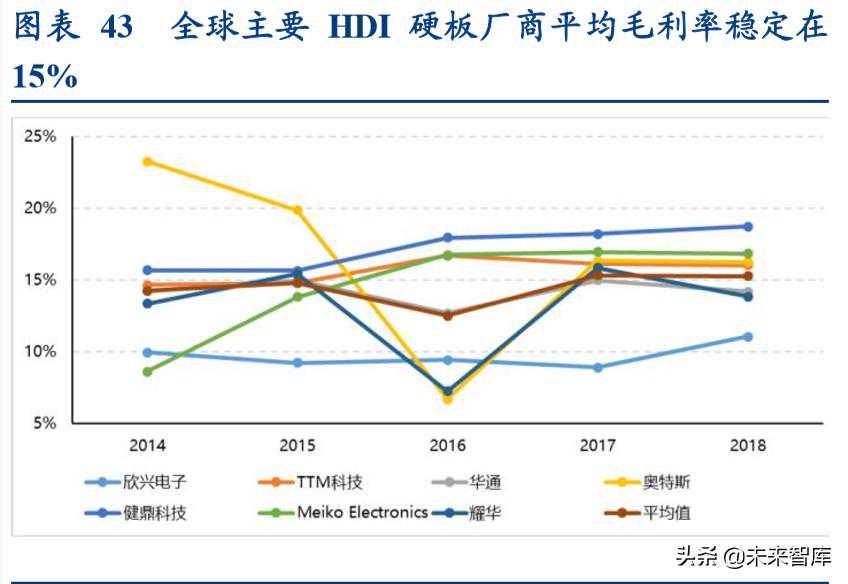
海外企业及台资企业扩产相对谨慎。通过分析全球主要HDI硬板厂商的资本开支情况,除了个别企业外,整体资本开始呈收紧趋势。2017年平均资本开支大幅提升是因为欣兴科技加大在IC载板和SLP主板的投入。HDI制造行业属于重资产行业,从投入到量产平均建设周期约两年,通过分析主流厂商资本投入情况,未来两年HDI产值不会大规模提升。

HDI行业竞争激烈,海外企业更甚退出市场。根据日本电子回路工业会数据显示,2016年/2017年/2018年日本PCB总产量分别为1,421/1,463/1,448万平米,同比-4%/+3%/-1%。随着中国大陆企业的崛起,日本PCB市场规模将继续萎缩。日本Panasonic先后关闭越南、台湾工厂,2015年卖掉山梨工厂正式退出HDI(PCB)制造业市场。2019年12月,韩国三星电机宣布关闭昆山HDI工厂,退出HDI行业。
(四)5G时代手机市场进入换机上行周期,高性能HDI主板有望持续放量
1.透过4G换机周期历史,5G手机渗透率有望于2020H1加速提升
复盘4G换机周期,我们判断2020年苹果与安卓手机阵营有望同步开启5G创新换机元年,并于21年继续量价维度渗透,3年可见上行周期内产业趋势明确。
信通院数据表明2014~2016年间全球4G机型出货量占比从70%提升至90%+水平,后续基本平稳向上,受益于4G技术迭代及运营商策略,2014年开始智能机市场明显复苏,进入4G智能机换机主旋律。同时,我们观察到国内智能机月出货量同比明显回升,仅2015~2016年间个别月份同比短期回落,2015年8月同比增速甚至高达50%+。两年间月平均增速维持10%+水平,同时4G新机型发布总数达2345只,月均新发机型近100款,基本覆盖高中低端全价位,新发4G新机占比从50%+稳步上升至90%,基本实现对3G机型全替代。——2017年后,4G换机潮开始衰退,2017H2以来国内智能机出货量持续呈现下滑趋势,2018Q2后月出货量跌幅逐步收窄,手机总体市场需求处于波动态势。复盘4G周期我们可以得知,随5G网络渗透,移动终端市场将于2020H1后进入新一轮换机周期,带动消费电子上游元器件产业步入上行通道,并有望于2020H2~2021H1加速凸显。

根据IDC和Canalys数据预测,2019年全球智能手机出货量下降触底达13.7亿台,同比下降2.2%,2020年回升至13.9亿部。2019~2024年全球5G智能手机出货量将从700万台增加到13亿台,5G手机渗透率有望从0.5%增长到80%。根据第三方研究和产业调研数据,我们预计2020年5G手机出货量约3亿部。手机作为HDI主板主要应用市场,智能手机市场回暖,将会成为带动HDI市场发展的重要因素。

2.手机市场回暖,2020年手机HDI主板市场规模有望超500亿元
Prismark数据显示,2013年全球HDI产值为81.21亿美元,至2018年全球HDI产值为92.22亿美元,年复增长率2.58%。近两年智能手机出货量下滑,导致HDI全球产值同比增速开始放缓,预计2019年总体产值会小幅下滑,约91.78亿美元。2019年四季度起5G智能手机开始导入市场,2020年H1将正式进入5G换机周期,手机市场回暖,HDI市场有望触底回弹。

手机主板跳阶升级,HDI主板的单机价值量也随之提升。根据产业链调研数据,二阶主板单价约2000元/平方米,HDI主板每提高一阶价格上涨约1000元/平方米,AnylayerHDI主板单价为约4000元/平方米,SLP主板单价约5500元/平方米。现阶段智能手机主板大小约0.01平方米,根据IDC数据推测,三星5G旗舰手机+iPhoneX及以上机型2020年出货量约2亿部,预计使用SLP主板约20万平方米;安卓系5G手机(除去三星旗舰机)出货量约2亿部,安卓系高端4G手机出货量2.5亿部,预计使用高阶AnylayerHDI主板约45万平方米;中低端4G手机合计约7.5亿部,预计使用三阶HDI主板约75万平方米。根据Prismark数据,2019年智能手机HDI主板市场规模约425亿元,我们预计2020年手机HDI主板市场规模515亿元,具有21.18%增长空间。
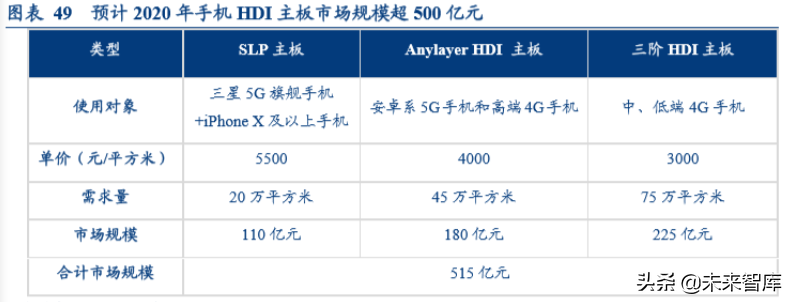
(一)东山精密:轻装上阵,5G产业布局共振进入业绩加速释放期
(二)深南电路:5GPCB龙头受益高频高速产业趋势,华为/中兴等通讯厂商绝对核心供应商
(三)沪电股份:产品结构持续优化,5G/IDC/汽车多核驱动盈利能力持续提升
(四)生益科技:高频CCL国产化核心标的,产品结构优化深度受益5G/IDC建设
(五)胜宏科技:智慧工厂助力产能效率提升,有望分食5G及服务器PCB市场
……
获取报告请登录未来智库。







